Low-temperature-sintering High thermal-conductivity Die Attach Adhesives Using MO Technology (conductive, sintering type)
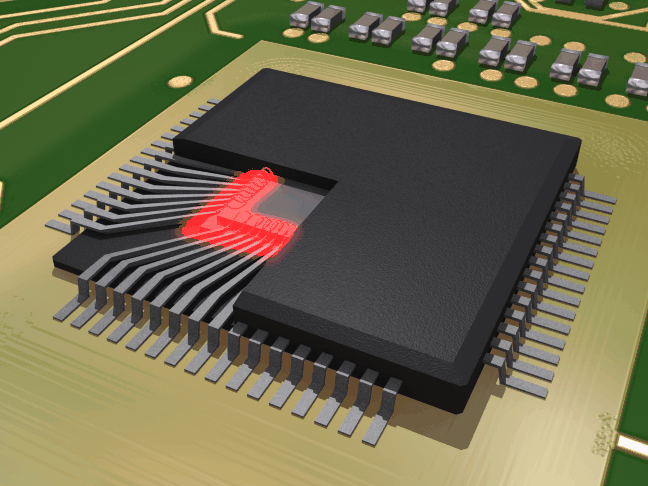
Key Features

Low-temperature sintered high thermally conductive die attach pastes using MO technology
Materials with higher heat-dissipation are required as device development seeks higher density and integration.
Low-temperature curable highly thermally conductive die attach materials has been developed using MO technology. Products are available including one that provides thermal conductivity of more than 200 W/mK.
Samples are available upon your request.
Property Data
| Product Number |
Characteristics | Applications | Viscosity [Pa・s] |
Curing Conditions |
Volume Resistivity [Ω・cm] |
Adhesive Strength [N/mm2] |
Thermal Conductivity [W/mK] |
|---|---|---|---|---|---|---|---|
| H9892-5 | Silver sintering material for pressure bonding Bond to bare copper substrate Good for temporary bonding of elements with heat Good for printing application |
Power IC SiC、GaN |
40 (E type 5rpm) | Pressure: 15MPa Temperature: 300Co Time: 2min. |
2.7×10-6 | 80 | 250 |
| H9888-2 | Silver sintering material for pressure-less bonding High density and very high thermal conductivity type Good for dispensing application |
Power IC SiC、GaN |
35 (E type 5rpm) | RT -> 210C for 62min, hold for 60min |
5×10-6 | 85 | 275 |
| H 9890-6A | Silver sintering material for pressure-less bonding High thermal conductivity type Good for dispensing application |
Power IC SiC、GaN |
30 (E type 5rpm) | RT -> 200C for 60min, hold for 60min |
8×10-6 | 50 | 140 |
| H 9890-10A | Silver sintering material for pressure-less bonding High thermal conductivity type with low bleed-out property Good for dispensing application |
Power IC SiC、GaN |
30 (E type 5rpm) | RT -> 200C for 60min, hold for 60min |
8×10-6 | 75 | 140 |
| H 9890-11 | Silver sintering material for pressure-less bonding Thermally conductive and low modulus type Good for dispensing application |
Power IC SiC、GaN |
30 (E type 5rpm) | RT -> 200C for 60min, hold for 60min |
15×10-6 | 35 | 60 |
Related Products
CONTACT
For inquiries or consultation regarding our products, please contact us on the following page.